ガラスコア テクノロジー
お問い合わせ [保護されたEメール] 次世代マイクロエレクトロニクスに関するご相談はこちらまでお問い合わせください。
超小型 | 高度な統合化 | ハイパフォーマンス
ガラス基板内の微細孔ガラス基板(TGV)
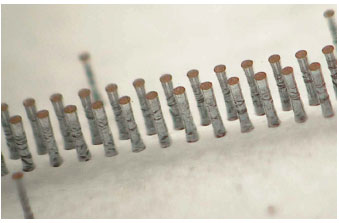
超高密度な微細孔ガラス基板(TGV)の金属化とハーメチックシーリングのために業界で唯一実績のあるプロセスでできること:
- 極度の小型化&統合
- ハイパフォーマンス エレクトロニクス
- 高信頼性パッケージング ソリューション
ガラス上に再配線層(RDL)回路パターン転写

RDLのユニークな薄膜プロセスで、ガラス基板に回路形成でき、これが以下を提供します:
- 低損失ファンアウト チップとパッケージ インターコネクト
- 従来のシリコンベースのインターポーザーと比べて低コスト
- 統合受動素子、フィルター
- エンドレスIoTアプリケーション
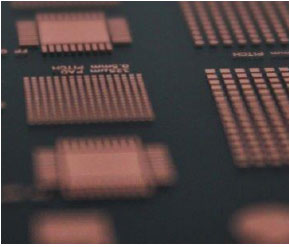
自動車用MEMSとセンサー
スマートビルのセンサーモジュール
医療用ロボット工学センサー
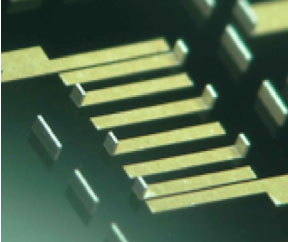
RFコンポーネント&モジュール
アドバンスドRF SiP
自動車用RF
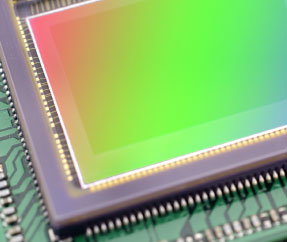
CMOSイメージセンサー(CIS)
自動車用カメラモジュール
アクティブイメージ&LiDAR
ソリッドステート医療用画像
ガラスコアテクノロジーの設計ルール&ガイドライン
注:
ここに記載される寸法は、製品を製造へといち早く移行させるための目安です。フル能力は、下記の仕様に限定されません。もっと要求の厳しいアプリケーションについては、 [保護されたEメール] までご相談ください。
微細孔ガラス基板(TGV)を実現したガラスインターポーザー
Samtecの微細孔ガラス基板(TGV)はガラスコアテクノロジー(例、ガラスインターポーザー、スマートガラス基板、ミクロ構造ガラス基板)を実現します。TGVを使用したガラス基板では、1つのウエハーにガラスと金属を統合でき、その上、インターポーザーがパッケージインターコネクトをさらに効率化し、製造サイクルタイムを向上します。
ハーメチックシールされたTGVは、高品質のホウケイ酸ガラス、溶融シリカ(別名、石英)、サファイヤで作製されます。高品質のガラスウエハー材料を使用し、アドバンスドインターコネクトテクノロジー(例、再配線層)を組み合わせることで、Samtecのガラスコアテクノロジーは独自のパッケージング製品を実現します。
| 微細孔ガラス基板の断面 |
|---|
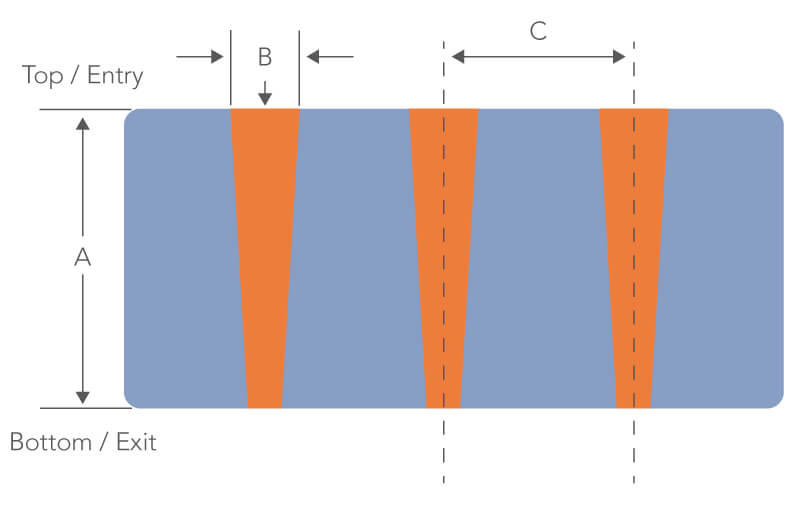 |
|
ガラス特性&アプリケーション
|
|---|
|
ホウケイ酸ガラス
溶融シリカ
|
| 詳細 | 単位 | |
|---|---|---|
| A | ガラス厚(公称) | 260 µm |
| B | ビア径(最小) | 40 µm |
| ビアテーパリング | 5° | |
| C | ビアピッチ | 2 x ビア径 |
| TTV(全体の厚みムラ) | 15 µm | |
| ビア位置精度 | +/- 5 µm |
再配線層(RDL)技術
Samtecの再配線層(RDL)技術では、ユニークな薄膜アプローチを介してTGVに接合し、ガラス基板上に回路形成ができます。これにより、チップとパッケージインターコネクトの低損失ファンアウトおよび従来のシリコンベースのインターポーザーと比べ低コストを実現します。
| 仕様 | 現在 | ロードマップ | |
|---|---|---|---|
| 面あたりの金属層の数 | 2 | 4 | |
| A | ガラスコア厚さ | 260 µm | 100 - 450 µm |
| ビア径 | 40 µm | 10 µm | |
| アニュラリング(キャッチパッド) | ビア径より20 µm大きい | ||
| ビアピッチ(最小) | 2 x 直径 | 40 µm | |
| D, E | ライン/間隔(最小) | 15 µm / 15 µm | 10 µm / 10 µm |
| F | 銅厚 | 1 - 5 µm | |
| G | 誘電体厚 1 & 2(最小) | 4 µm | |
| はんだボールタイプ | SN63Pb37およびSAC305 | Pb95Sn5、Pb90Sn10、Cu/Snピラー | |
| バンプ下冶金(UBM) | ENIG | ENIPIG |
| トップ/ボトムRDL回路の平面図 |
|---|
 |
| 断面図 - 2つの金属層(現在の能力) |
|---|
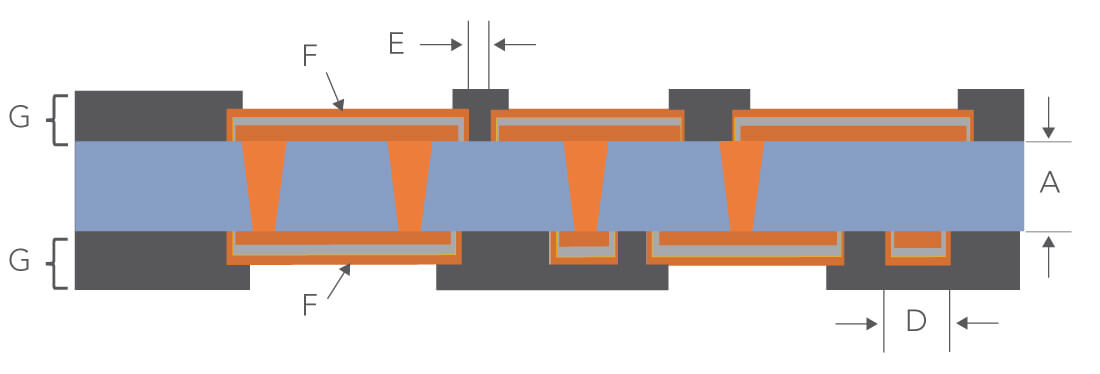 |
| 断面図 - 4つの金属層(将来的な能力) |
|---|
-cross-section.jpg) |
SamtecのガラスコアテクノロジーとアドバンスドICパッケージング能力の詳細は、 samtec.com/microelectronicsよりご覧ください。[保護されたEメール] 次世代マイクロエレクトロニクスのニーズについてはこちらより当社の専門家にご相談ください。



 プライバシー設定
プライバシー設定