玻璃芯技术
联系方式 [email protected] ,我们将协助您满足新一代微电子需求。
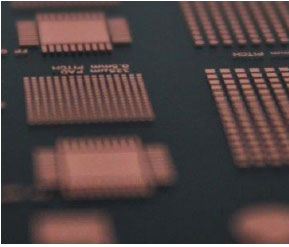
汽车MEMS和传感器
智能建筑传感器模块
医疗机器人传感器
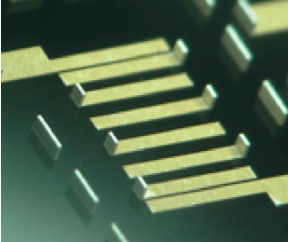
射频组件和模块
先进的射频系统级封装
汽车射频
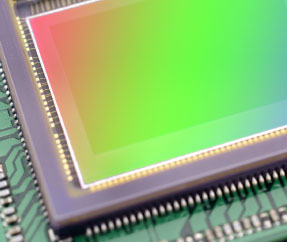
CMOS图像传感器(CIS)
汽车相机模块
主动图像与激光雷达
固态医学图像
玻璃通孔(TGV)启用型玻璃转接板
Samtec玻璃通孔(TGV)使玻璃芯技术(即玻璃转接板、智能玻璃基板和微结构玻璃基板)成为可能。支持TGV的玻璃基板能够将玻璃和金属集成到单个晶片中,而转接板可以让封装互连器与生产周期更高效。
气密式TGV由高品质硼硅玻璃、熔融石英和蓝宝石制成。通过使用高质量的玻璃晶圆材料以及先进的互连技术(如重布线层),Samtec的玻璃芯技术能够缔造独一无二包装的产品。
| 玻璃通孔横截面视图 |
|---|
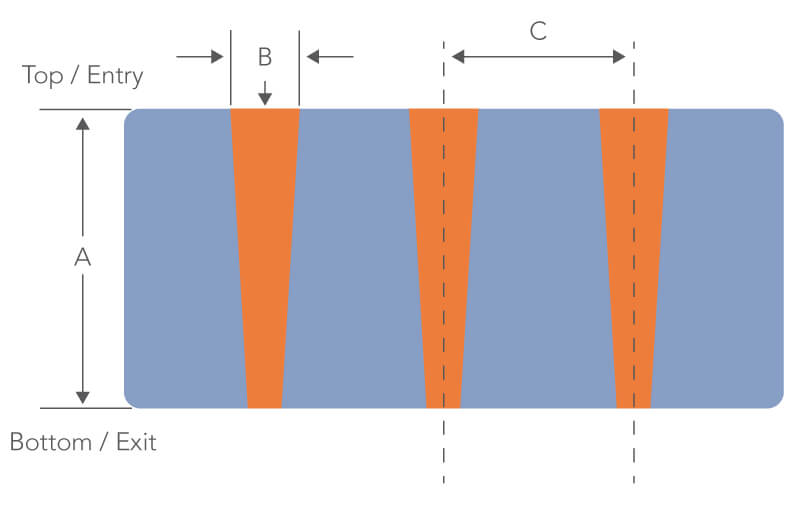 |
|
玻璃特性与应用
|
|---|
|
硼硅玻璃
熔融石英
|
| 详情 | 单位 | |
|---|---|---|
| A | 标称玻璃厚度 | 260 µm |
| B | 通过直径 (最小值) | 40 µm |
| 通过狭带 | 5 deg | |
| C | 通过间距 | 2倍通过直径 |
| 总厚度变量 (TTV) | 15 µm | |
| 通过定位精确度 | +/- 5 µm |
重布线层(RDL)技术
Samtec的重布线层(RDL)技术能够通过独特的薄膜方法在玻璃基材上形成电路,以此连接TGV。这样就提供芯片与封装互连器的低损耗输出端,以及比传统硅基转接板更低的成本。
| 规格 | 电流 | 路线图 | |
|---|---|---|---|
| 每侧金属层数 | 2 | 4 | |
| A | 玻璃芯厚度 | 260 µm | 100 - 450 µm |
| 通过直径 | 40 µm | 10 µm | |
| 环形圈(接垫) | 20 µm 大于通过直径 | ||
| 通过间距(最小值) | 2 倍直径 | 40 µm | |
| D, E | 行/间距(最小值) | 15 µm / 15 µm | 10 µm / 10 µm |
| F | 铜厚度 | 1 - 5 µm | |
| G | 介质厚度 1 & 2 (最小值) | 4 µm | |
| 焊球类型 | SN63Pb37和SAC305 | Pb95Sn5、Pb90Sn10、Cu/Sn支柱 | |
| 凸点下金属化层 (UBM) | ENIG | ENIPIG |
| 顶部/底部RDL的电路顶视图 |
|---|
 |
| 横截面2金属层(当前载流量) |
|---|
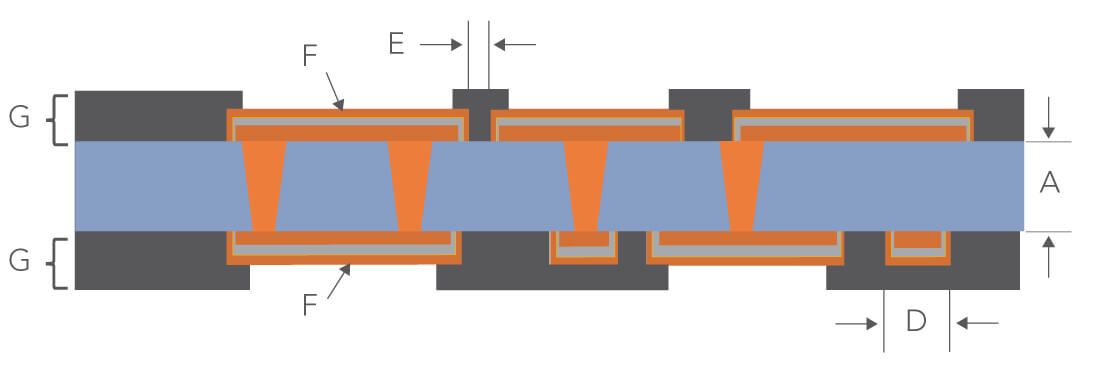 |
| 横截面4金属层(未来载流量) |
|---|
-cross-section.jpg) |
访问samtec.com/microelectronics,了解更多有关Samtec玻璃芯技术和先进IC封装功能的信息。 请联系 [email protected] ,与我们的专业人士讨论您对新一代微电子的需求。

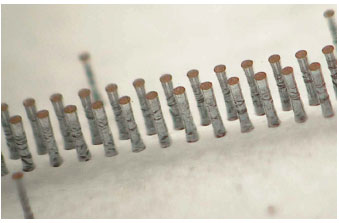



 您的隐私选择
您的隐私选择