GLASS-CORE-TECHNOLOGIE
Kontakt [E-Mail geschützt] wenn Sie Unterstützung bei Ihren Anforderungen an die Mikroelektronik der nächsten Generation benötigen.
ULTRA-MINIATURISIERT | HOCHINTEGRIERT | HOHE LEISTUNG
GLAS-DURCHKONTAKTIERUNGEN (TGV) IN GLASSUBSTRATEN
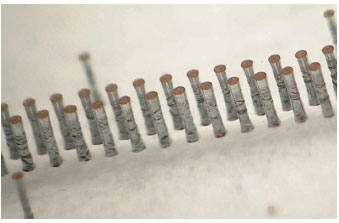
Das branchenweit einzig bewährte Verfahren zur Metallisierung und hermetischen Versiegelung von ultra-hochdichten Glas-Durchkontaktierungen (TGV) ermöglicht:
- Extreme Miniaturisierung und Integration
- Hochleistungsfähige Elektronik
- Hoch zuverlässige Packaging-Lösungen
REDISTRIBUTION LAYER (RDL) Verschaltungsmuster AUF GLAS

Das einzigartige RDL-Dünnschichtverfahren ermöglicht die Bildung von Schaltkreisen auf Glassubstraten und sorgt so für:
- Verlustarmes Fan-Out von Chip- und Package-Bauteilen
- Geringere Kosten im Vergleich zu herkömmlichen siliziumbasierten Interposern
- Integrierte passive Bauelemente, Filter
- Endlose IoT-Applikationen
HOCHLEISTUNGSFÄHIGE ELEKTRONIK

Glassubstrate bieten hohe strukturelle Integrität, Vibrations- und Temperaturbeständigkeit, Robustheit gegenüber Umwelteinflüssen und geringe elektrische Verluste, was sie ideal für die Anforderungen der nächsten Generation von Mikroelektronik macht. Der von Samtec entwickelte Glass-Core-Technologieprozess nutzt die Leistungsvorteile von Glas, um leistungsoptimierte, ultra-miniaturisierte Substrate für Designs der nächsten Generation zu ermöglichen.
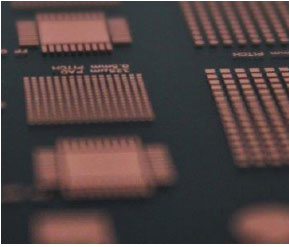
Automobil-MEMS und -Sensoren
Sensormodule für intelligente Gebäude
Medizinische Robotiksensoren
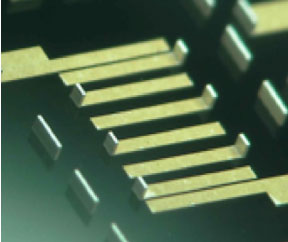
HF-Komponenten und -Module
Fortgeschrittene HF-SiP
Automobil-HF
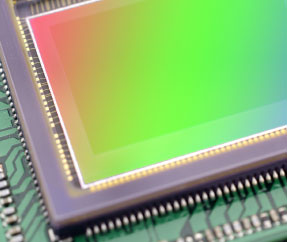
CMOS-Bildsensor (CIS)
Automobile Kameramodule
Aktive Bilder und LiDAR
Medizinische Festkörper-Bilder
DESIGNREGELN UND RICHTLINIEN FÜR DIE GLASS-CORE-TECHNOLOGIE
HINWEIS:
Diese Abmessungen sind Richtlinien, die dazu dienen, das Produkt so schnell wie möglich in die Produktion zu bringen. Das gesamte Leistungsvermögen ist nicht auf die unten aufgeführten Spezifikationen beschränkt. Bitte wenden Sie sich an unseren [E-Mail geschützt] für Anwendungen mit höheren Anforderungen.
THROUGH GLASS VIA (TGV) ERMÖGLICHEN GLAS-INTERPOSER
Samtecs Through Glass Via (TGV) ermöglichen Glass-Core-Technologie (d. h. Glas-Interposer, intelligente Glassubstrate und mikrostrukturierte Glassubstrate). TGV-fähige Glassubstrate ermöglichen die Integration von Glas und Metall in einen einzigen Wafer, während Interposer für effizienteres Packaging und Fertigungszykluszeiten sorgen.
Die hermetisch dichten TGV werden aus hochwertigem Borosilikatglas, Quarzglas und Saphir hergestellt. Durch die Verwendung von hochwertigem Glaswafermaterial, kombiniert mit fortschrittlichen Verbindungstechnologien (z. B. Redistribution Layer), ermöglicht die Glass-Core-Technologie von Samtec ein einzigartiges Packaging-Produkt.
| Through-Glass Via Querschnittansicht |
|---|
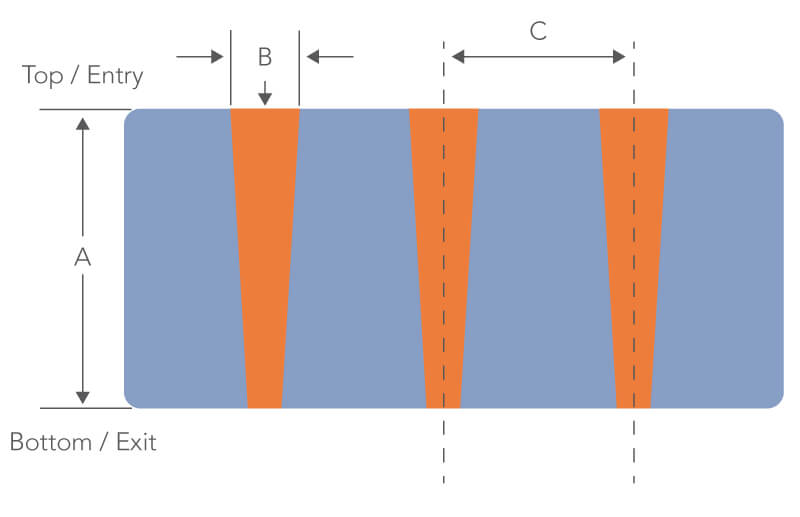 |
|
Glaseigenschaften und Anwendungen
|
|---|
|
Borosilikatglas
Quarzglas
|
| Detail | EINHEITEN | |
|---|---|---|
| A | Nominale Glasstärke | 260 µm |
| B | Via Durchmesser (min) | 40 µm |
| Via Verjüngung | 5 Grad | |
| C | Via Raster | 2 x Via Durchmesser |
| Gesamtdickenschwankung (TTV) | 15 µm | |
| Via Positionsgenauigkeit | +/- 5 µm |
REDISTRIBUTION LAYER (RDL)-TECHNOLOGIE
Samtecs Redistribution Layer (RDL)-Technologie ermöglicht die Schaltungsbildung auf Glassubstraten für die Anbindung an TGV über einen einzigartigen Dünnschichtansatz. Dies sorgt für einen verlustarmes Fan-Out von Chip- und Packaging-Bauteilen und geringere Kosten im Vergleich zu herkömmlichen Interposern auf Siliziumbasis.
| Technische Daten | Aktuell | Fahrplan | |
|---|---|---|---|
| Anzahl der Metallschichten pro Seite | 2 | 4 | |
| A | Glass-Core-Dicke | 260 µm | 100 – 450 µm |
| Via Durchmesser | 40 µm | 10 µm | |
| Ringförmiger Ring (Fangkissen) | 20 µm größer als Via-Durchmesser | ||
| Via Raster (min) | 2 x Durchmesser | 40 µm | |
| D, E | Zeile/Abstand (min) | 15 µm/15 µm | 10 µm/10 µm |
| F | Kupfer-Dicke | 1 – 5 µm | |
| G | Dielektrische Dicke 1 und 2 (min) | 4 µm | |
| Lötkugel-Typen | SN63Pb37 und SAC305 | Pb95Sn5, Pb90Sn10, Cu/Sn Säulen | |
| Under Bump Metallization (UBM) | ENIG | ENIPIG |
| Draufsicht der Schaltung für Oben/Unten-RDL |
|---|
 |
| Querschnitt – 2 Metallschichten (aktuelle Fähigkeit) |
|---|
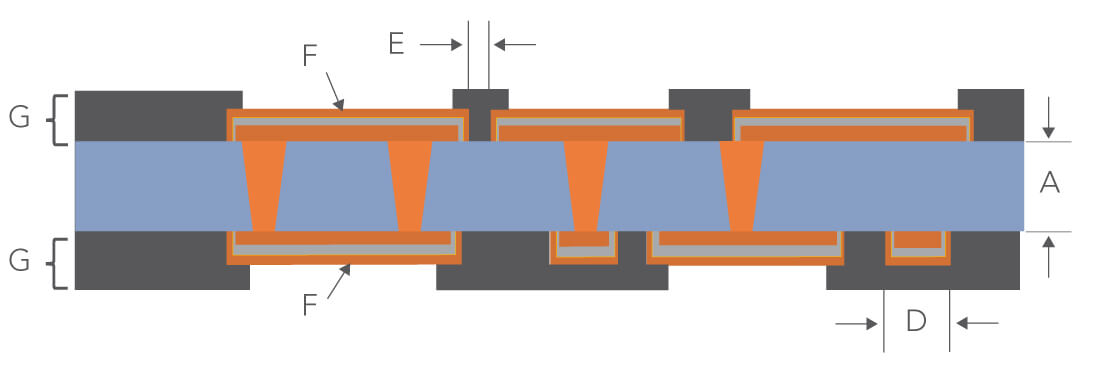 |
| Querschnitt – 4 Metallschichten (zukünftige Fähigkeit) |
|---|
-cross-section.jpg) |
Besuchen Sie samtec.com/microelectronics, um weitere Informationen über die Glass-Core-Technologie von Samtec und hoch entwickelte IC-AVT zu erhalten. Kontakt [E-Mail geschützt] , um mit unseren Experten über Ihre Anforderungen an die Mikroelektronik der nächsten Generation zu sprechen.
